Varför och hur man använder GaN-fälteffekttransistorer för effektiva, switchade krafttillämpningar med högre spänning
Bidraget med av DigiKeys nordamerikanska redaktörer
2023-01-26
Energieffektivitet är en prioriterad fråga för elektroniska system med tanke på både samhälleliga och lagstadgade krav. I synnerhet för tillämpningar som sträcker sig från elfordon till högspänningskommunikation och industriell infrastruktur är effektomvandlingseffektivitet och effekttäthet avgörande för att konstruktionen ska bli framgångsrik.
För att uppfylla dessa krav måste konstruktörer av switchade kraftsystem byta från att använda klassiska kiselbaserade MOSFET:ar och bipolära transistorer med isolerad gate (IGBT), eftersom de snabbt närmar sig sina teoretiska gränser.
Istället måste konstruktörer överväga enheter baserade på material med brett bandgap (WBG), som t.ex. galliumnitrid (GaN). GaN-enheter switchar snabbare än Si-enheter, klarar högre spännings- och effektnivåer, är mycket mindre för en given effektnivå och arbetar med mycket högre verkningsgrad.
Artikeln behandlar grunderna för GaN FET:ar, deras fördelar jämfört med traditionella Si-enheter i switchade kraftkretsar, verkliga exempel från Nexperia och deras tillämpning.
Grunderna för GaN FET:ar
De grundläggande elementen i kraftomvandlingskretsar är högspänningsomkopplare av halvledarmaterial. Konstruktörerna har fokuserat på att förbättra prestandan hos dessa enheter genom att minska ledningsförlusterna genom att minska serieresistansen i tillslaget läge, minska switchningsförlusterna genom att öka övergångshastigheterna och minska parasitära effekter. Dessa konstruktionsinsatser har i allmänhet varit framgångsrika för kisel-MOSFET:ar och IGBT:er, men förbättringstakten har avtagit i takt med att användningen av dessa enheter når sina teoretiska gränser.
Detta har fått till följd att men under de senaste åren introducerat WBG-enheter som använder kiselkarbid (SiC) och GaN och som nu har nått volymproduktion. Dessa enheter erbjuder högre driftsspänningsområden, snabbare switchningstider och högre verkningsgrad.
Bandgapet hos en halvledare är den minsta energi som krävs för att excitera elektroner så att de frigörs från sitt bundna tillstånd till ett fritt tillstånd så att de kan leda elektricitet (tabell 1).
|
Tabell 1: En sammanfattning av de viktigaste egenskaperna som särskiljer halvledare med brett bandgap, t.ex. GaN och SiC, från Si. (tabellkälla: Art Pini)
Enheter som tillverkas med halvledare med brett bandgap kan fungera vid mycket högre spänningar, frekvenser och temperaturer än konventionella halvledarmaterial som Si. Det bredare bandgapet är särskilt viktigt för att möjliggöra att enheterna kan fungera i mycket högre temperaturer. Den höga temperaturtoleransen innebär att enheterna under normala förhållanden kan drivas med mycket högre effektnivåer. WBG-halvledare med ett högre kritiskt elektriskt fält och högre rörlighet har den lägsta drain-source-resistansen i påslaget tillstånd (RDS(ON)), vilket minskar ledningsförlusterna.
De flesta material med brett bandgap har även höga hastigheter för fria elektroner, vilket gör att de kan arbeta med högre switchningshastigheter.
Jämfört med Si, som har ett bandgap på 1,12 eV, är GaN och SiC sammansatta halvledare med ett bandgap som är cirka tre gånger högre, 3,4 eV respektive 3,3 eV. Det innebär att båda kan stödja högre spänningar och högre frekvenser.
Den högre elektronrörligheten i GaN gör den mycket lämpligare för högeffektiva högfrekvenstillämpningar. De snabbare switchningshastigheterna och högre driftfrekvenserna som GaN power FET:ar möjliggör, resulterar i förbättrad signalstyrning, passiva filterkonstruktioner med högre gränsfrekvenser och lägre rippelströmmar. Detta gör det möjligt att använda mindre induktorer, kondensatorer och transformatorer, vilket leder till minskad total storlek och vikt.
GaN FET:ar kallas transistorer med hög elektronrörlighet (HEMT). Den höga elektronrörligheten är en funktion av FET-strukturen (figur 1).
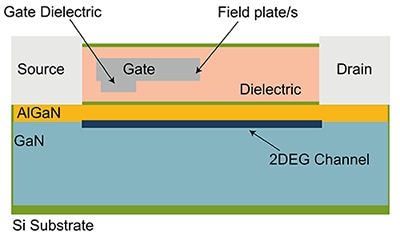 Figur 1: En tvärsnittsbild på en GaN FET baserad på ett Si-substrat. (Bildkälla: Nexperia)
Figur 1: En tvärsnittsbild på en GaN FET baserad på ett Si-substrat. (Bildkälla: Nexperia)
GaN FET:ar använder befintliga produktionsanläggningar för kisel-CMOS, vilket gör dem kostnadseffektiva. Ett GaN-skikt bildas på Si-substratet genom att ett grundlager och ett graderat lager av GaN med ett lager av aluminiumgalliumnitrid (AlGaN) som isoleringslager (visas inte i diagrammet) deponeras innan det rena GaN-skiktet växer. Ett andra AlGaN-skikt deponeras ovanpå GaN-skiktet. Detta skapar en piezoelektrisk polarisering, med ett överskott av elektroner som genereras omedelbart under AlGaN, som är en mycket ledande kanal. Detta överskott av elektroner kallas en tvådimensionell elektrongas (2DEG). Namnet återspeglar den mycket höga elektronrörligheten i detta lager.
Ett utarmningsområde bildas under gaten. Gaten fungerar på samma sätt som en N-kanalig, effekt-MOSFET av kisel med förstärkningsläge. En positiv spänning på gaten i denna enhet slår på den.
Strukturen upprepas flera gånger för att bilda en effektenhet. Slutresultatet är en i grunden enkel, elegant och kostnadseffektiv lösning för switchning av ström.
För att få en enhet med högre spänning ökas avståndet mellan drain och gate. Eftersom motståndskraften hos GaN 2DEG är mycket låg är effekten på resistansen genom att öka spänningskapaciteten mycket lägre jämfört med kiselenheter.
GaN FET:ar kan konstrueras för att fungera i en av två konfigurationer, förstärkningsläge eller utarmningsläge. FET:ar i förstärkningsläge är normalt avstängda, så en positiv spänning i förhållande till drain/source måste läggas på gaten för att slå på FET:en. FET:ar i utarmningsläge är normalt på, så en negativ gate-spänning i förhållande till drain/source måste tillämpas för att stänga av FET:en. FET:ar i utarmningsläge är problematiska i ett kraftsystem eftersom en negativ förspänning måste appliceras på GaN FET:en i utarmningsläge innan systemet sätts igång.
Ett sätt att komma runt detta problem är att kombinera en lågspännings-FET av kisel med en GaN-FET med utarmningsläge i en kaskadkrets (figur 2).
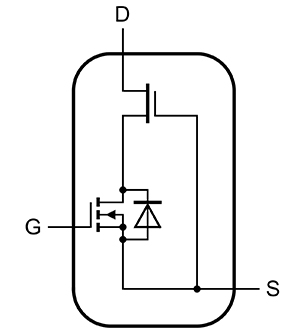 Figur 2: En lågspännings-MOSFET av kisel i en kaskadkonfiguration med en GaN FET med utarmningsläge resulterar i robustheten hos Si-gatens struktur med förbättrade klockningsegenskaper vid hög spänning hos GaN-enheten, samt att den sammansatta enheten är avstängd när strömmen slås på, i fallet med en GaN FET med utarmningsläge. (Bildkälla Nexperia)
Figur 2: En lågspännings-MOSFET av kisel i en kaskadkonfiguration med en GaN FET med utarmningsläge resulterar i robustheten hos Si-gatens struktur med förbättrade klockningsegenskaper vid hög spänning hos GaN-enheten, samt att den sammansatta enheten är avstängd när strömmen slås på, i fallet med en GaN FET med utarmningsläge. (Bildkälla Nexperia)
I kaskadkretsen används gate-strukturen i Si MOSFET:en som har fördelarna med högre gränser för gatestyrningen som är anpassade till befintliga MOSFET-gatedrivkretsar och att GaN FET:n i uttömningsläge är avstängd vid start.
En av de viktigaste egenskaperna hos GaN FET:ar är deras höga effektivitet. Detta beror på följande: låg serieresistans, vilket minskar ledningsförlusterna, snabbare omkopplingstider för att minska switchningsförlusterna, och lägre laddning för återvinning i omvänd riktning, vilket förklarar de låga förlusterna vid återvinning i omvänd riktning.
Med hjälp av en vanlig boost-omvandlare med halvbrygga, kan man jämföra verkningsgraden hos GaN FET:ar och Si MOSFET:ar (figur 3).
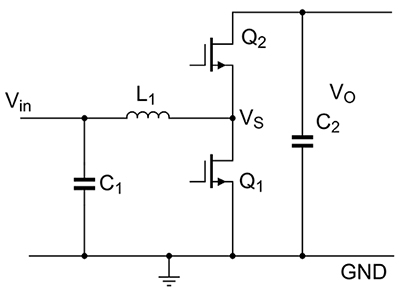 Figur 3: Här visas schemat för en boost-omvandlare med halvbrygga, som används för att jämföra verkningsgraden hos MOSFET:ar och GaN FET:ar genom att byta ut transistorerna Q1 och Q2 mot respektive typ. (Bildkälla: Nexperia)
Figur 3: Här visas schemat för en boost-omvandlare med halvbrygga, som används för att jämföra verkningsgraden hos MOSFET:ar och GaN FET:ar genom att byta ut transistorerna Q1 och Q2 mot respektive typ. (Bildkälla: Nexperia)
Boost-omvandlaren har en inspänning på 240 V, utspänningen är 400 V och kopplingsfrekvensen är 100 kHz. Verkningsgraden och förlusterna jämförs i ett effektområde på upp till 3 500 W (figur 4).
 Figur 4: En jämförelse av verkningsgrad och effektförlust mellan GaN FET:ar och MOSFET:ar i en identisk krets, vilket visar fördelarna med GaN FET:ar. (Bildkälla Nexperia)
Figur 4: En jämförelse av verkningsgrad och effektförlust mellan GaN FET:ar och MOSFET:ar i en identisk krets, vilket visar fördelarna med GaN FET:ar. (Bildkälla Nexperia)
GaN FET:arna har cirka 20 % högre verkningsgrad jämfört med MOSFET:arna, och effektförlusten är ungefär tre gånger lägre. Vid 2 000 W är förlusten i MOSFET:arna ca 62 W; i GaN FET:arna är den bara 19 W. Det innebär att kylsystemet kan vara mindre, vilket förbättrar boost-omvandlarens volymeffektivitet.
Mindre uppenbart är att mätningen utfördes med nästan 3 500 W för GaN FET:en tack vare dess högre maximala spänningsgräns. GaN FET:en har därför en klar fördel.
Komma igång med GaN för högre spänningar
För tillämpningar med högre spänning erbjuder Nexperia två GaN FET:ar på 650 V, GAN063-650WSAQ och GAN041-650WSBQ. Båda är N-kanals FET:ar som normalt är avstängda. GAN063-650WSAQ kan hantera en maximal spänning från drain till source på 650 V och kan klara en transient (med en pulsbredd på mindre än en mikrosekund) på 800 V. Den är dimensionerad för en drain-ström på 34,5 A och en effektförlust på 143 W vid 25 °C. Motståndet mellan drain och source vid tillslag är vanligtvis 50 mΩ, med en maximal gräns på 60 mΩ.
GAN041-650WSBQ har samma maximala spänning på 650 V från drain till source och samma transientgräns på 800 V. Den skiljer sig åt genom att den kan hantera en maximal drain-ström på 47,2 A och en maximal effektförlust på 187 W i rumstemperatur. Det typiska kanalmotståndet är 35 mΩ, med ett maximum på 41 mΩ.
En referenskonstruktion från Nexperia som använder GAN063-650WSAQ i en konfiguration med halvbrygga visas i figur 5.
 Figur 5: Rekommenderad konstruktion för ett effektsteg med halvbrygga med GaN FET:arna GAN063-650WSA. Schemat visar endast FET-drivkretsen och halvbryggans utgångssteg samt tillhörande komponenter. (Bildkälla: Nexperia)
Figur 5: Rekommenderad konstruktion för ett effektsteg med halvbrygga med GaN FET:arna GAN063-650WSA. Schemat visar endast FET-drivkretsen och halvbryggans utgångssteg samt tillhörande komponenter. (Bildkälla: Nexperia)
Schemat visar Si8230 hög/låg dubbel isolerad grinddrivkrets, som används för att driva gaten på GaN FET:ar. Gatedrivkretsen är ansluten till gaten via en gateresistor på 30 Ω, vilket krävs för alla GaN-enheter. Gate-resistorn styr laddningstiden för grindens kapacitet, vilket påverkar den dynamiska switchningsförmågan. R-C-nätverken mellan FET:arnas drain och source hjälper också till att styra switchningsförmågan. Nivåerna för gatestyrning i GaN FET är mellan 0 och 10-12 V.
GaN FET:arnas höga switchningshastighet (typiskt 10-11 ns) kräver noggrann layout för att minimera parasitär induktans och användning av RC-släckare för att dämpa ringning på grund av spännings- och strömtransienter. Det finns flera RC-släckare (R17 till 19 och C33 till 35) i konstruktionen mellan högspänningsförsörjningen och jord. Släckarna minskar den ringning som orsakas av interaktionen mellan GaN FET:en och förbikopplingsnätverket. Släckare ska anslutas så nära drain på primärsidans FET som möjligt. De är implementerade med ytmonterade resistorer och keramiska kondensatorer med lågt effektivt seriemotstånd (ESR) för att minimera ledningsinduktansen.
Komponentnätverket som bildas av R4, D1, C12 och C13 är en bootstrap-strömförsörjning för primärsidans gatedrivkrets. D1 bör vara en snabb diod med låg kapacitans, eftersom dess övergångskapacitans bidrar till switchningsförlusten. R4 begränsar strömrusningen; ett värde i intervallet 10 till 15 Ω fungerar bra.
Sammanfattning
Behovet av högre effektivitet och effekttäthet i kraftomvandlingen, från elfordon till kommunikation och industriell infrastruktur, kräver ett skifte från klassiska Si-strukturer. GaN FET:ar är som visats en väg framåt för nästa generations konstruktioner genom att erbjuda högre driftsspänningar, snabbare switchningstider och högre verkningsgrad. Komponenter som finns på lager och som i vissa fall stöds av referenskonstruktioner hjälper konstruktörer att snabbt komma igång med sina projekt.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.